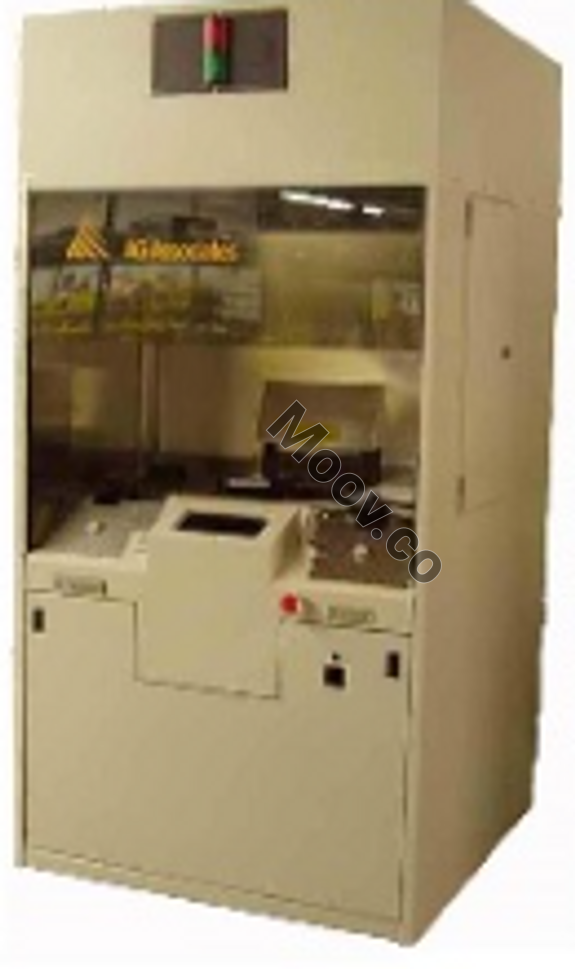
描述
The AG Associates Heatpulse4100 rapid thermal anneal system contains a subsystem for each of the following: • Electronics (including a dedicated microprocessor) • Mass-flow-controlled gas handling • Cooling • ULPA filtration • Mechanical assemblies AG Associates Heatpulse 4100 Rapid Thermal Anneal equipment APPLICATIONS: The Heatpulse 4100 system is a versatile tool which can be useful for many applications, such as (but not limited to): • Silicon dielectric growth • Implant annealing • Glass re-flow • Silicide formation and annealing • Nitridation of metals • Contact alloying • Oxygen donor annihilation AG Associates Heatpulse 4100 Physical Dimensions Width: 40 in. (102 cm) Depth 42 in. (107 cm) Height 82 in. (208 cm) Weight:: 1800 lbs (816 kg)配置
The following are the operating specifications for the Heatpulse® 4100 system. Wafer handling: automatic serial processing, using standard cassettes. Throughput: Process dependent, approximately 80 wafers per hour (in a null cycle) without flat-finder. Wafer sizes: 3 inches, 4 inches, 5 inches, 6 inches (standard). Ramp-up rate: Programmable, 1 – 180°C per second. Steady-state duration: 1 – 600 seconds per step. Ramp-down rate: Programmable, 1 – 180°C per second. Ramp-down rate is temperature and radiation dependent, maximum 150°C per second. Recommended steady-state temperature range: 400 – 1200°C. ERP temperature accuracy: +5°C to -9°C, when calibrated against an instrumented thermocouple wafer (ITC). Temperature repeatability: + 7°C or better at 1150°C wafer to wafer. (Repetition specifications are based on a 100-wafer set.) Temperature uniformity: + 10°C across an 6-inch wafer at 1150°C. (This is a 1-sigma deviation from 100-angstrom oxide uniformity.) For a titanium silicidation process, no more than 1.5 percent increase to uniformity during the first anneal at 650 – 700°C.OEM 代工型號說明
A single-wafer, cassette-to-cassette rapid thermal processor, capable of processing in inert or corrosive ambient.文檔
無文檔
類別
RTP/RTA
上次驗證: 超過60天前
關鍵商品詳情
條件:
Refurbished
作業狀態:
未知
產品編號:
138381
晶圓尺寸:
3"/75mm, 4"/100mm, 5"/125mm, 6"/150mm
年份:
未知
Logistics Support
Available
Transaction Insured by Moov
Available
Refurbishment Services
Available
METRON / AG ASSOCIATES
HEATPULSE 4100
類別
RTP/RTA
上次驗證: 超過60天前
關鍵商品詳情
條件:
Refurbished
作業狀態:
未知
產品編號:
138381
晶圓尺寸:
3"/75mm, 4"/100mm, 5"/125mm, 6"/150mm
年份:
未知
Logistics Support
Available
Transaction Insured by Moov
Available
Refurbishment Services
Available
描述
The AG Associates Heatpulse4100 rapid thermal anneal system contains a subsystem for each of the following: • Electronics (including a dedicated microprocessor) • Mass-flow-controlled gas handling • Cooling • ULPA filtration • Mechanical assemblies AG Associates Heatpulse 4100 Rapid Thermal Anneal equipment APPLICATIONS: The Heatpulse 4100 system is a versatile tool which can be useful for many applications, such as (but not limited to): • Silicon dielectric growth • Implant annealing • Glass re-flow • Silicide formation and annealing • Nitridation of metals • Contact alloying • Oxygen donor annihilation AG Associates Heatpulse 4100 Physical Dimensions Width: 40 in. (102 cm) Depth 42 in. (107 cm) Height 82 in. (208 cm) Weight:: 1800 lbs (816 kg)配置
The following are the operating specifications for the Heatpulse® 4100 system. Wafer handling: automatic serial processing, using standard cassettes. Throughput: Process dependent, approximately 80 wafers per hour (in a null cycle) without flat-finder. Wafer sizes: 3 inches, 4 inches, 5 inches, 6 inches (standard). Ramp-up rate: Programmable, 1 – 180°C per second. Steady-state duration: 1 – 600 seconds per step. Ramp-down rate: Programmable, 1 – 180°C per second. Ramp-down rate is temperature and radiation dependent, maximum 150°C per second. Recommended steady-state temperature range: 400 – 1200°C. ERP temperature accuracy: +5°C to -9°C, when calibrated against an instrumented thermocouple wafer (ITC). Temperature repeatability: + 7°C or better at 1150°C wafer to wafer. (Repetition specifications are based on a 100-wafer set.) Temperature uniformity: + 10°C across an 6-inch wafer at 1150°C. (This is a 1-sigma deviation from 100-angstrom oxide uniformity.) For a titanium silicidation process, no more than 1.5 percent increase to uniformity during the first anneal at 650 – 700°C.OEM 代工型號說明
A single-wafer, cassette-to-cassette rapid thermal processor, capable of processing in inert or corrosive ambient.文檔
無文檔